BGA是大规模集成电路的一种极富生命力的封装方法。通常BGA的安装高度低,引脚间距大,引脚的共面性好,这些都极大改善了组装的工艺性。由于它的引脚更短,组装密度更高,所以特别适合在高频电路中使用。存在的问题是:焊后检查和维修比较困难,必须使用X射线检测,才能确保焊接的可靠性;易吸潮,使用前应经过烘干处理。
BGA焊球的尺寸为0.75~0.89mm,焊球间距有40mil,50mil,60mil几种,引脚数目为169~480个。下图所示是
几种典型的BGA结构。
- 塑料BGA(PBGA),如图(a)所示,基板一般为由2~4层有机材料构成的多层板。Intel系列CPU中,Pentium I、IIl、IV处理器均采用这种封装形式。
- 柔性微型BGA(TBGA),如图(b)所示。
- 载带自动键合BGA(TBGA),如图(c)、(d)所示,基板为带状软质的1~2层电路板。
- 陶瓷BGA(CBGA),如图(e)所示,陶瓷基板、芯片与基板间的电气连接通常采用倒装芯片(Flip Chip),简称FC的安装方式。Intel系列CPU中,Pentium I、Il、Pentium Pro处理器均采用过这种封装形式。
- CDPBGA(Carity Down PBGA):指封装中央有方型低陷的芯片区(又称空腔区)。
- CCGA(Ceramic Column Grid Array):陶瓷柱栅阵列。
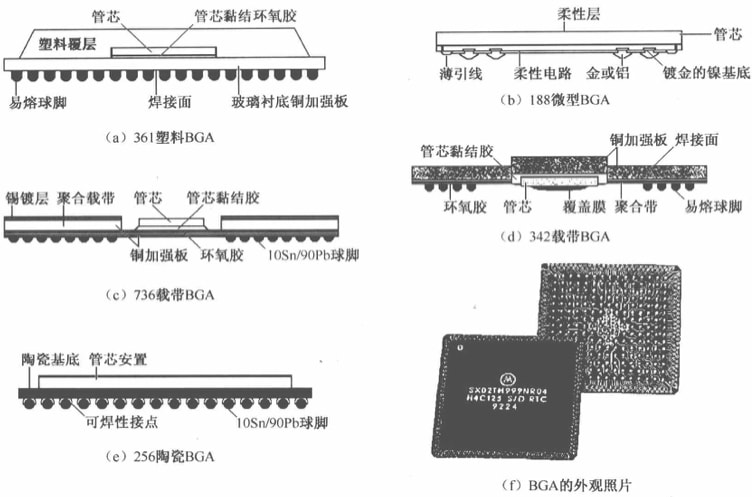
随着全球电子产品个性化、轻巧化的需求蔚为风潮,封装技术已进步到CSP(Chip Size Package),它减小了芯片封装外形的尺寸,封装后的IC尺寸边长不大于芯片的l.2倍,IC面积只比晶粒(Die)大不超过1.4倍。
CSP封装分为以下四类:
- 传统导线架形式(Lead Frame Type),代表厂商有富士通、日立、Rohm和高士达。
- 硬质内插板型(Rigid Interposer Type),代表厂商有摩托罗拉、索尼、东芝和松下等。
- 软质内插板型(Flexible Interposer Type),代表厂商有Tessera、CTS、GE和NEC。
- 晶圆尺寸封装(Wafer Level Package),有别于传统的单一芯片封装方式,WLCSP是将整片晶圆切割为一个个单一芯片,它号称是封装技术的未来主流,已投入研发的厂商包括FCT、Aptos、卡西欧、EPIC、富士通和三菱电子等。
CSP封装
- 适用于脚数少的IC,如内存条和便携电子产品。未来则将大量应用在信息家电(IA)、数字电视(DTV)、电子书(E-Book)、无线网络WLAN/GigabitEthemet、ADSL/手机芯片和蓝牙(Bluetooth)等产品中。
PGA插针网格阵列封装的芯片封装形式
- 在芯片的内外有多个方阵形的插针,每个方阵形插针沿芯片的四周间隔一定距离排列。根据引脚数目的多少,可以围成2~5圈。安装时,将芯片插入专门的PGA插座。为使CPU能够更方便地安装和拆卸,从486芯片开始,出现一种名为ZIF的CPU插座,专门用来满足PGA封装的CPU在安装和拆卸上的要求。在Intel系列CPU中,80486、Pentium和Pentium Pro均采用这种封装形式。
ZIF(Zero Insertion Force Socket)是指零插拔力的插座
- 把这种插座上的扳手轻轻抬起,CPU就可容易、轻松地插入插座中,然后将扳手压回原处,利用插座本身的特殊结构所生成的挤压力,将CPU的引脚与插座牢牢地接触,绝对不存在接触不良的问题,而拆卸CPU芯片时只需将插座的扳手轻轻抬起,压力解除,CPU芯片即可轻松取出。
PGA封装的特点:插拔操作更方便,可靠性高:可适应更高的频率。
芯片组装器件
- 表面组装技术的发展,使电子组装技术中的集成电路固态技术和厚薄膜混合组装技术同时得到发展,这个结果促进了半导体器件芯片的组装与应用,正向微组装技术(FPT)的方向发展,即用芯片级组装代替板级组装技术。
- 芯片组装器件主要有载带自动键合(TAB)、倒装芯片(FC)、芯片直接组装到电路板上(COB),凸点载带自动键合(BTAB)、微凸点连接(MBB),以及陶瓷多层组装(MCM)等。芯片组装器件具有可批量生产,通用性好,工作频率高,速度快等优点,目前已大量应用在大型液晶显示器、液晶电视机、摄录机及精密计算机等产品中。
以上内容是集成电路的封装之三的BGA封装结构;CSP封装类型;PGA封装形式;及芯片组装器件等内容。
© 版权声明
文章版权归作者所有,未经允许请勿转载。
相关文章

暂无评论...



